半导体材料迭代与腾盛切割探索方向
发布时间:2022-08-09 08:41:37 浏览:69次 责任编辑:腾盛精密

随着电子产品向小型化趋势发展,对芯片性能和体积的要求越来越高。在半导体发展过程中,新兴材料出现,芯片表面的薄化及平坦化处理在整个芯片加工过程中显得愈发重要。高精度的切割、研磨工艺对有效控制产品破损率、提高芯片良率有着极大帮助。新兴材料的出现会带来了哪些机遇? 半导体切割工艺在未来会有怎样的发展趋势?
一、半导体材料概述
半导体材料作为半导体产业链上游的重要环节,在芯片的生产制造过程中起到关键性作用。根据芯片制造过程划分,半导体材料主要分为基体材料、制造材料和封装材料。
➊基本材料:硅晶圆片、化合物半导体
➋制造材料:电子特气、溅射靶材、光刻胶、抛光材料、掩膜版、湿电子化学品
➌封装材料:芯片粘结材料、键合丝、陶瓷封装材料、引线框架、封装基板、切割材料

化合物半导体材料的演进情况
第一代半导体材料是以硅(Si)、锗(Ge)为主,第二代半导体材料是以砷化镓(GaAs)、锑化铟(lnSb)为主。以碳化硅(SiC)、氮化镓(GaN)、氧化锌(ZnO)、金刚石、氮化铝(AIN)为代表的宽禁带半导体材料,被称为第三代半导体材料,目前发展较为成熟的是碳化硅(SiC)和氮化镓(GaN)。

与传统材料相比,第三代半导体材料更适合制造耐高温、耐高压、耐大电流的高频大功率器件。近些年,SiC和GaN市场火热,关注度极高。凭借先天优势,SiC和GaN确实有良好的发展前景,特别是在高功率应用方面,会是将来的主流。不过,就整个化合物半导体应用市场而言,无论是当下,还是可预见的未来,以GaAs为代表的第二代化合物半导体仍是市场的主导力量。因为与硅相比,GaAs最大的优势在于工作温度高(最高可以到摄氏350度左右)、耐热、抗辐射、发光效率也很高,基于这样的特性,GaAs主要用于三个领域:射频(RF),约占47%,发光二极管(LED ),约占42%、激光二极管(LD),约占10%。5G时代,GaAs仍将主导智能手机PA(射频功率放大器)市场。
总之,从当下和未来化合物半导体市场总量来看,GaAs和InP依然占据绝大部分,而SiC和GaN则会在高功率应用领域逐步扩大占有率。
新的第三代半导体材料行业是我国重点鼓励发展的产业,是支撑经济社会发展和保障国家安全的战略性和基础性产业。为加快推进第三代半导体材料行业的发展,国家层面先后印发《重点新材料首批次应用示范指导目录(2019版)》、《国务院关于印发进一步鼓励软件产业和集成电路产业发展若干政策的通知》等鼓励性、支持性政策;而地方层面也积极响应,通过政策将实质性的人、
财、物资源注入,推动着各地半导体材料产业的集聚和发展。

半导体材料细分形成三大梯队
政策扶持、市场需求、资本进入、技术迭代是中国半导体材料产业快速发展、市场规模持续扩大的主要推力。目前,中国半导体材料对于进口产品的依赖程度仍然较高,而且根据细分产品竞争力和国产化进度,由强到弱可以将中国半导体材料产业分为三大梯队。不同材料产业进入壁垒、中国企业进入时间阶段和参差不齐的技术积累是使得半导体材料形成三大梯队的主要原因。

当前半导体材料国产化进度参差不齐∶其中抛光材料、溅射靶材、引线框架等已经达到世界一流水平;电子特种气体、掩膜板等材料产品已进入量产,技术上已向世界领先水平看齐;光刻胶等材料仍处于向领先技术学习的阶段,虽已实现阶段性的技术突破,但还未能实现大规模量产,量产是下一步发展目标。
纵观整个半导体材料领域,由于其技术壁垒高、生产难度大、验证周期长等特点,导致大部分半导体材料都处于寡头垄断的局面,核心技术长期掌握在欧美、日本、德国、韩国等国家手中。
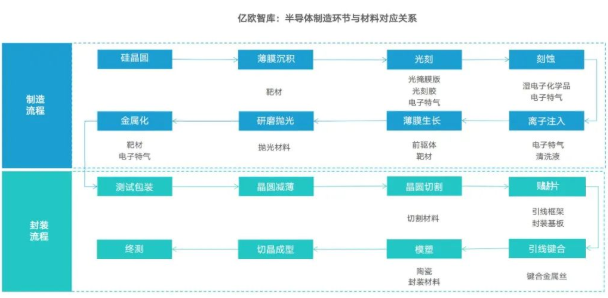
其中,日本就供应了全球超50%的半导体材料,例如全球超70%的光刻胶均由日本生产,由JSR、东京应化、信越化学、富士电子4家企业瓜分。而在半导体制造过程所需的19种核心材料中,日本就占到了14种,处于绝对领先地位。此外在硅片市场,2018年全球近90%的市场都被日本、中国 、德国、韩国占据,市场集中度非常高。
相比之下,我国本土半导体材料行业起步晚、发展慢,加之本土市场长期被国外巨头牢牢占据,导致本土企业呈现“小而散”的格局。不过,随着国产替代浪潮的推动,如今越来越多的本土企业开始切入半导体材料领域,大大推动了国产半导体行业技术自主性的发展。
二、紧跟材料更迭步伐,深耕工艺
随着化合物半导体的多样化发展,材料有很多新的变化,对切割时使用的工具和切割过程的控制而言都是新的挑战。
切割、划片其实是半导体产业中的一个细枝分节点,但我们遇到的半导体材料几乎都需要切割,不管是用激光切割、刀片切割,还是用裂片的方式,总要经过这一道工序。 比如,以前 PCB,Wafer的切割可能只需要一把硬刀或一把软刀就能应对。但现在越来越多的Wafer会加入玻璃、铜等材料,还有WLCSP封装,molding之后的封装,和以前相比,现在的材料对切割和研磨的要求十分高。挑战很大,但也潜藏着新的机遇。 在材料的发展过程中,如果厂家的工艺、技术迭代跟不上,就会丢失大量的客户,一部分跟不上新材料更迭的厂家会被淘汰。
Tensun腾盛高精密半导体切割系统经韩国专家团队精心研制多年,且经过行业知名客户验证与日本同行对比性能、功能完全可与之媲美的高精密半导体刀片式切割系统,可应用于半导体晶片、LED晶片 & EMC导线架、 PCB、 IR/滤光片、蓝宝石玻璃、 陶瓷薄板等材料的精密切割。目前,腾盛精密也已成为行业内第一家推出无膜切割兼容贴膜切割的厂商。
在Wafer Saw切割工艺领域中,考虑到间距发展越来越小,未来可能会向玻璃基或其他材料更加稳定的方向发展,因此,腾盛精密的设备集中在切边方面,保证芯片到下一个基板之间拼接的间隙。以全自动切割系统ADS2100为例,该机台采用创新布局方案,每个料盒可以存放20-25层料片,自动上料、位置校准、切割、清洗/干燥、下料均可由本系统自动完成,切割性能以150微米厚度bumping晶圆为例,正面崩边低于5微米,背面崩边低于7微米,侧面深度符合预设值标准,切割道偏移量低于2微米,可以满足8~12寸材料的高精密切割加工,该机台还可双主轴同时切割,比单主轴切割产能提高85%以上,高低倍双定位识别影像系统 ,适用多材料加工,并实时监测系统的气压、水压、电流等数值,避免主轴损伤。

8-12寸双轴精密全自动划片机ADS2100
同时在基板划片领域,腾盛精密研发出中国第一台双工位自动切割&分选一体机,也实现了两大工序合一,可大大提升封测厂商生产效率。

未来,中国半导体材料行业挑战与机遇并存。人们对于新材料的应用有着巨大的憧憬,随着工艺技术的成熟,在未来,我们也期待更多新材料能够广泛用于人们的生活,更多让人新奇、惊喜的新兴应用走进我们生活。TENSUN腾盛精密也将继续深耕技术工艺,打造符合时代进步的半导体切割系统,助力推动国内半导体技术的发展,和广大半导体相关企业共同建设稳定的半导体行业产业链,维持中国半导体行业的可持续发展。

————
声明:本文部分内容参考出处有:
1.「中国半导体制造及封装材料行业报告」,来源:亿欧智库
2.「化合物半导体制造格局生变」,作者:畅秋
如有侵权等行为,可联系我方删除。
 深圳市腾盛精密装备股份有限公司
深圳市腾盛精密装备股份有限公司