VR设备轻薄化趋势下,SiP封装成关键
发布时间:2022-12-06 17:14:53 浏览:45次 责任编辑:腾盛精密

VR/AR等智能穿戴设备的小型化,对硬件芯片提出了体积要求,如何在更小的空间内构建功能更加丰富的芯片系统成为难题。系统级封装(Syste in Packag,SiP)成为VR赛道上的玩家首选,从晶圆制造到封装的半导体供应链上的厂家有望成为直接受益者。
竞逐元宇宙赛道
VR/AR产业迎来高速发展期
元宇宙被认为是下一代互联网的流量密码,而VR(虚拟现实)作为元宇宙重要入口,当前已经成为炙手可热的赛道。
随着交互技术进步以及5G网络加速普及,VR生态内容不断优化、受众群体快速扩张,VR新品频出,谷歌、苹果、腾讯、华为等科技巨头纷纷提前布局。
 ▲2016-2024年全球VR出货|图源:安信证券
▲2016-2024年全球VR出货|图源:安信证券
根据智研咨询数据,2021年全球VR头显出货量达1095万台,全球 VR 设备出货突破千万台,行业迎来高速发展期。2022年上半年,索尼、松下、小派科技等多个厂商陆续推出VR头显新品。而下半年Pico、创维和Oculus的发售计划也在进行,其中Pico Neo4于国内9月27日召开新品发布会;创维 Pancake1于8月上市,年底将上市Pancake 1 Pro。Meta、Pico即将发布VR新品,苹果MR备受关注。据IDC数据,2022年Q2全球VR头显出货量233万台,其中Meta出货量为182万台,居全球第一;Pico出货量为26万台,居国内第一。
在“元宇宙”概念加持下,VR/AR行业发展态势良好,高景气有望持续。
VR一体机为终端发展趋势
更轻、更薄
随着半导体应用市场对于芯片性能的不断追求,芯片制造的成本也在持续增加,创新的先进封装技术的出现也成为必然。对于传统封装方式的创新,促成了晶圆级封装技术的“应运而生”。
从结构简单的VR眼镜,到VR头显,再到近年来兴起的VR一体机,VR设备硬件逐步升级换代。
最初为了画面的清晰呈现,VR头显需要和电脑或手机连接,以此提高芯片处理性能和储存能力。但随着消费者对VR设备无绳化、轻便化的需求提高,市面上便出现了具备独立处理器的VR一体机。
综观市面上的VR装置,从Meta旗下的Oculus Quest 2、HTC的VIVE Focus 3、爱奇艺旗下VR厂商爱奇艺智能Dream VR,一直到中国VR硬体领导厂商Pico推出的Neo3系列,全都为一体式的设计。

▲Pico Neo3一体机
VR一体机为终端发展趋势,显示屏、芯片、光学器件成本占比最高。根据华经产业研究院2021年数据,显示屏、芯片、光学器件占据了VR一体机的主要成本, 分别占比约 33.9%、43.7%、5.5%。
其中,Pancake方案的光学路线是折叠光路,优势在于减重和变焦,能够实现更短的光路设计,从而大幅缩小产品体积,实现产品减重,同时提高VR头显的佩戴舒适度。今年新发布的或即将发布的VR设备大都采用了Pancake方案。

▲Pancake方案原理|图源:安信证券
Pancake光学主要依赖光的偏振特性,通过在光学系统内来回反射,光经过多次反射后利用率低,因此头显需要搭配高亮度屏幕。当前的VR设备为兼顾分辨率、刷新率以及生产成本,主要应用Fast-LCD屏幕。同时,高分辨率、高刷新率的Micro OLED以及Mini LED也拥有良好的发展前景。
Mini LED是传统LED背光基础上的改良版本,作为LCD面板的背光源使用。但Mini LED背光渗透率有望提升,被视为是Micro LED的过渡期。Micro OLED可以在维持相近分辨率水平的基础上显示面积更小的OLED,使得它拥有更高的像素密度(PPI),微米级别的像素间距,成像效果更优秀。
Micro LED具备低功耗、高亮度、高对比度、反应速度快、厚度薄的性能优势,有望成为VR显示技术的最终解决方案,但当前受限于巨量转移技术尚未突破,量产难度较高。
一体式VR更看重系统整合的能力。VR所需的芯片,包含传感器、Wi-Fi,以及多颗运算芯片(如CPU、GPU、NPU)等,加起来会有超过10颗以上的裸片,它们都来自不同的晶圆厂,制程也有差异。

▲松下MeganeX
要达成一体设计,VR装置就需在更小的空间内整合更多的芯片,并且提供高解析度与足够的运算能力。其中,系统级整合能力则是关键。目前市面上VR硬件搭载的芯片大多数是高通的骁龙系列芯片。但是一想到智能手机行业被高通芯片支配的恐惧,一些企业早早地为VR硬件布局自研芯片。苹果作为科技行业的风向标,其VR硬件都倾向于采用自研的芯片,那么其他厂商大概率会效仿,因此自研芯片可能会是VR硬件的未来发展方向。
同时,VR/AR等智能穿戴设备的小型化,对硬件芯片提出了体积要求,如何在更小的空间内构建功能更加丰富的芯片系统成为难题。
SiP封装技术成为VR设备的关键
系统级封装(Syste in Packag,SiP)成为VR赛道上的玩家首选。SiP是将多种功能芯片,包括处理器、存储器、FPGA等功能芯片集成在一个封装内,从而实现一个基本完整的功能。与系统级芯片(System on Chip, SoC)相对应,不同的是系统级封装是采用不同芯片进行并排或叠加的封装方式,而 SoC 则是高度集成的芯片产品。
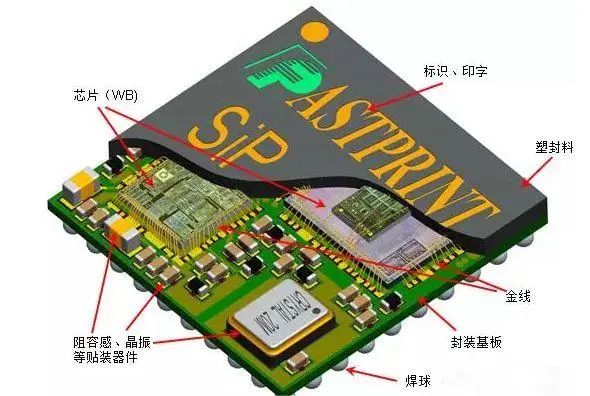
▲图源:电子制造技术
由于体积过小,无法每颗芯片都封装,因此采用裸片的方式叠在载板上,再进行封装,缩小芯片并腾出更多位置摆放电池,这也是现在VR装置的设计方式。
与其他封装类型相比,SiP 技术有四大明显的优势:
1.能够将性能不同的有源或无源元件集成在一种 IC 芯片上,并且能够集成复杂的异质元件,从而形成一个功能完整的系统或者子系统。
2.通过增加芯片之间的连接的直径和缩短信号传输的距离,可以提升性能并降低功耗,这反过来又可以降低驱动这些信号所需的功率。
3.所有模块和 chiplet(小芯片)都在一个封装中,让 IP 复用变得简单。
4.不同的芯片排列方式,与不同的内部接合技术搭配,使 SIP 的封装形态产生多样化的组合,并可依照客户或产品的需求加以定制化或弹性生产。
SiP封装制程按照芯片与基板的连接方式可分为引线键合封装和倒装焊两种。
引线键合封装工艺
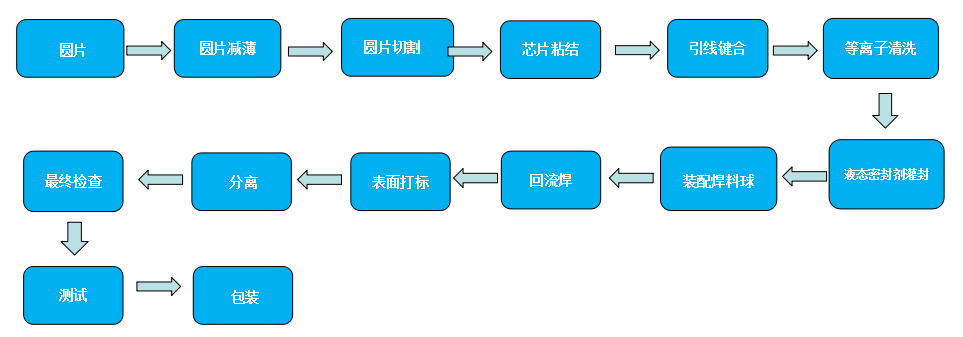
▲图源:电子制造技术
倒装焊工艺流程

▲图源:电子制造技术
SiP封装制程按照芯片与基板的连接方式可分为引线键合封装和倒装焊两种。在SiP工艺中,点胶和划片是十分重要的步骤,技术要求非常严苛。
Tensun腾盛为了满足更加紧凑的电子器件布局,专门针对芯片级点胶开发的高精度自动点胶机Sherpa91N配合典型胶材,可实现极高的喷射胶点位置重复精度及胶量稳定性,实测结果显示,其芯片级Underfill最窄KOZ能做到0.21mm、最小单点直径0.21mm。
在半导体精密划片领域,Tensun腾盛亦有创新。晶圆划片设备采用全自动切割系统,高低倍双定位识别影像系统,能够自动完成上料、位置校准、切割、清洗/干燥、下料等工序,双主轴同时切割,适用多材料多尺寸加工;基板划片设备采用双工位自动切割&分选一体机,实现了两大工序合一,可大大提升封测厂商生产效率。
VR浪潮最直接的受益者将会是从晶圆制造到封装的半导体供应链。Tensun腾盛作为国内最早研制12吋切割设备的企业,将时刻做好技术储备,成为行业内技术领先且值得信赖的半导体精密设备制造企业。

————
声明:本文部分内容参考出处有:
1.「VR设备行业研究深度报告 」,来源:未来智库
2.「SIP封装工艺流程」,来源:电子制造技术
3.「VR硬件进化史:从“盒子”到“笼子”」,来源:OFweek VR网
如有侵权等行为,可联系我方删除。



 深圳市腾盛精密装备股份有限公司
深圳市腾盛精密装备股份有限公司